- 技术(专利)类型 发明专利
- 申请号/专利号 CN201310306968.2
- 技术(专利)名称 硅基高迁移率Ⅲ-V/Ge沟道的CMOS制备方法
- 项目单位 中国科学院半导体研究所
- 发明人 周旭亮;于红艳;李士颜;潘教青;王圩
- 行业类别 电学
- 技术成熟度 详情咨询
- 交易价格 ¥面议
- 联系人 李志文
- 发布时间 2021-07-15
 北京
北京
客服热线:010-83278899
 微信公众号 扫一扫 关注我们
微信公众号 扫一扫 关注我们

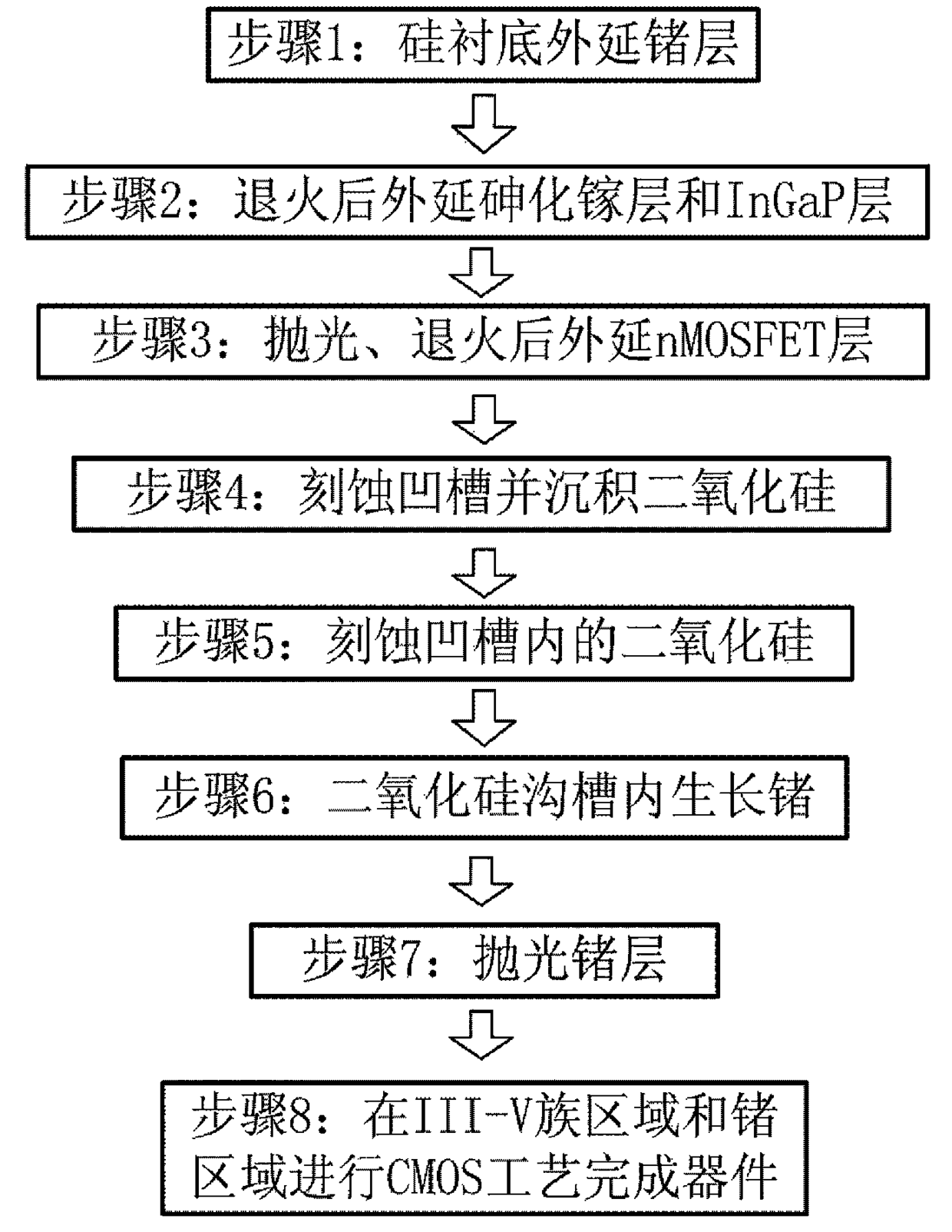
项目简介
说明书
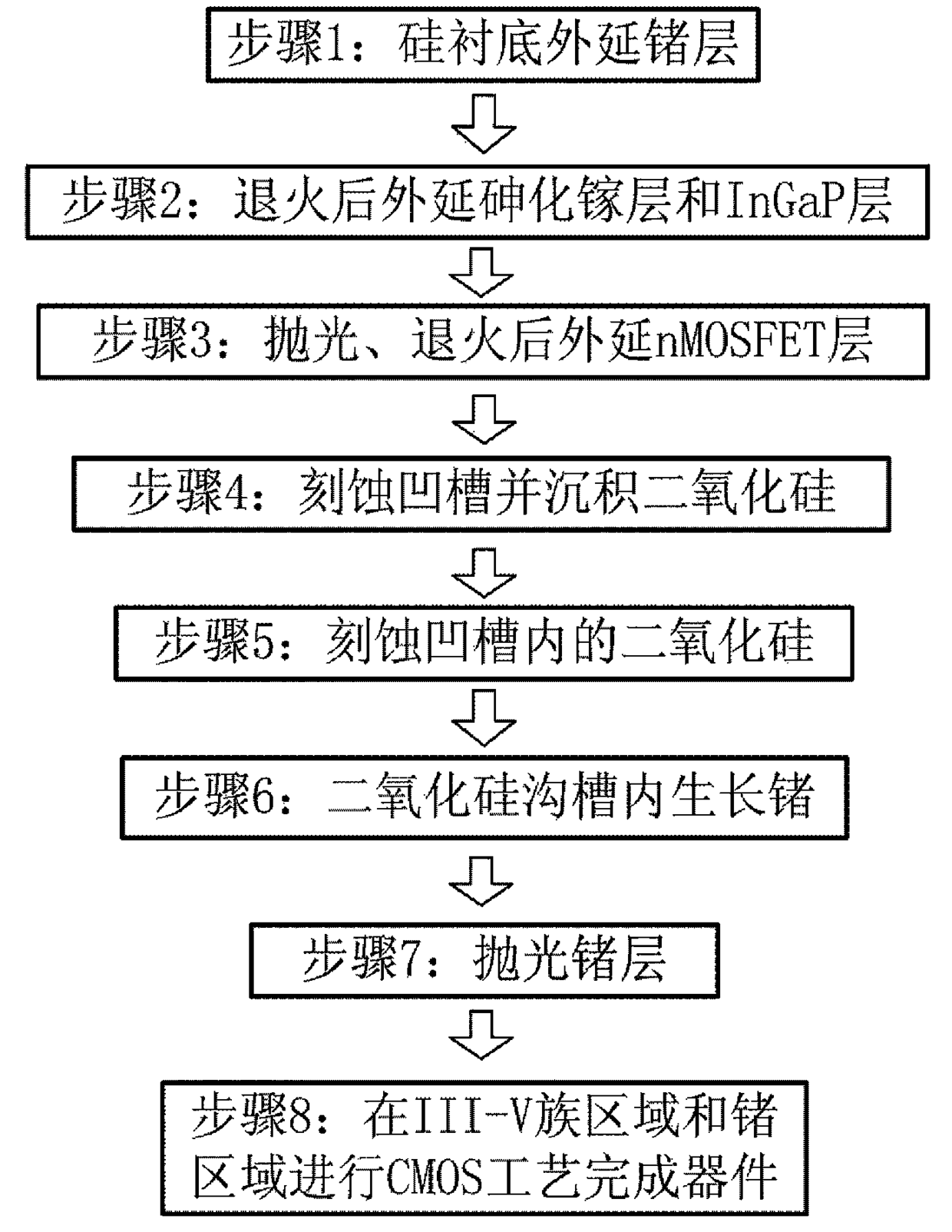
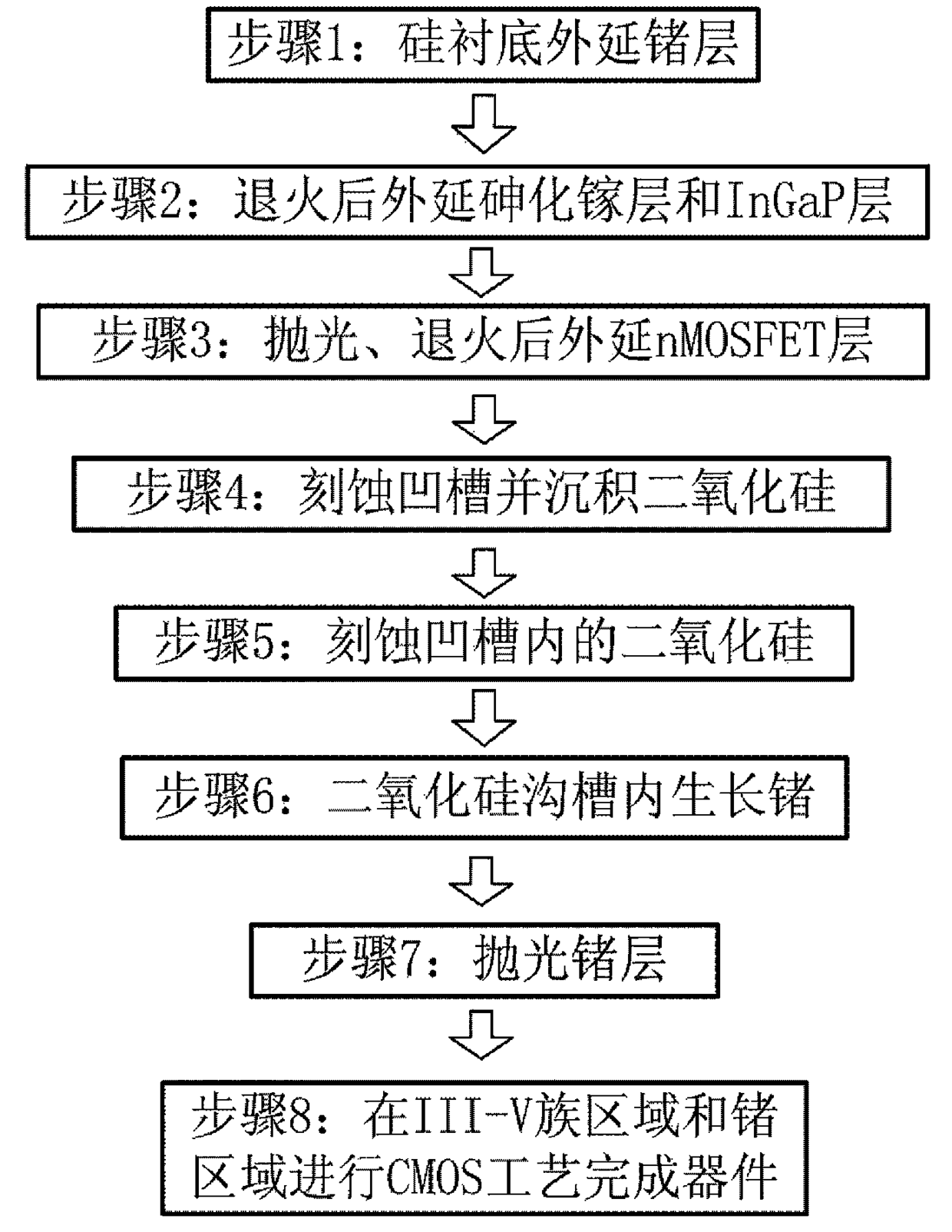

企业营业执照
专利注册证原件
身份证
个体户营业执照
身份证
专利注册证原件
专利代理委托书
转让申请书
转让协议
手续合格通知书
专利证书
专利利登记簿副本





提交